Menü
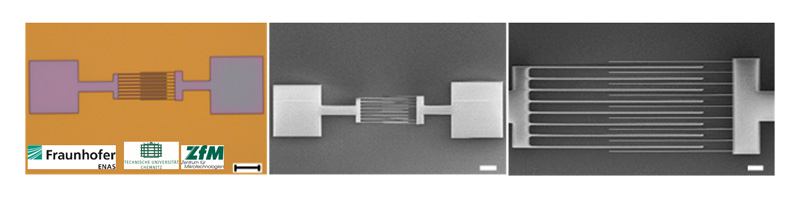
Mikroskop- und REM-Aufnahmen der gefertigten Devices, i-line stepper & e-beam belichtet - Mit freundlicher Genehmigung FhG-ENAS/ TUC-ZfM, Germany
Die fortschreitende Miniaturisierung in der Halbleiterindustrie und der Mikrosystemtechnik erfordert die Herstellung von zunehmend kleineren und komplexeren Strukturen mit hohen Anforderungen an die Präzision und Auflösung bis in den Nanometer-Maßstab. Der mix & match Ansatz bzw. die hybride lithographische Strukturierung, welche die Kombination von mindestens zwei verschiedenen Strukturierungstechnologien in einer Resistschicht beinhaltet, ist eine Methode zur Herstellung komplexer Strukturen mit unterschiedlichen Dimensionen im µm bis in den sub-100 nm Maßstab bei gleichzeitig deutlich reduzierter e-beam Schreibzeit und verkürzter Lithographie-Prozesszeit.
Die Verwendung des ma-N 1400, eines klassischen UV-empfindlichen Negativresists, eingesetzt in typischen Strukturübertragungsprozessen z.B. als Ätzmaske in nass- und trockenchemischen Ätzprozessen, wird in einem mix & match Strukturierungsverfahren demonstriert.
Referenzen
https://doi.org/10.1016/j.mne.2023.100189
Zugehörige Produktseiten

© All rights reserved: micro resist technology GmbH / Gestaltung und Umsetzung: onthewall GmbH
micro resist technology ist in Europa zentrale Anlaufstelle für Spezialchemikalien mit Anwendung in der Mikro- und Nanofabrikation. Das Portfolio der eigengefertigten Produkte wird durch den strategischen Vertrieb assoziierter Produkte ergänzt, die durch unsere internationalen Partner hergestellt werden. Hier agieren wir als High-Service-Distributor und bieten dem europäischen Mittelstand ein breites Spektrum an komplementären Produkten aus einer Hand, die sowohl für etablierte als auch für innovative Produktions- und Fertigungsverfahren eingesetzt werden können.
DuPont Electronic Solutions (ehm. DOW Electronic Materials / Rohm and Haas Europe Trading ApS)
Wir bieten Produkte für Semiconductor Technologies, Advanced Packaging und Trockenfilmresiste unseres Partners DuPont an, mit dem wir seit mehr als 20 Jahren zusammenarbeiten.
Kayaku Advanced Materials, Inc. (ehm. MicroChem Corp.)
Wir bieten Photoresiste und Spezialchemikalien für MEMS und Mikroelektonik-Anwendungen unseres Partners Kayaku Advanced Materials an, mit dem wir seit mehr als 20 Jahren zusammenarbeiten.
DJ MicroLaminates, Inc.
Wir bieten Trockenfilmresiste für MEMS, Mikrofluidik und Packaging-Anwendungen unseres Partners DJ MicroLaminates an, mit dem wir seit über zwei Jahren kooperieren.
Trockenfilme sind anwendungsfertige Polymerfilme als Laminat mit einer hohen Schichtdickengenauigkeit und exzellenten Haftungseigenschaften auf verschiedensten Untergründen. Sie sind einfach in der Verarbeitung, foto-strukturierbar und sowohl als zugeschnittene Bögen als auch als Rollenmaterial verfügbar.
Spezielle Funktionsmaterialien aus den Produktgruppen Hybridpolymere, Photoresiste und Nanoimprint Polymere für die Beschichtung und alternative Strukturierung mittels Inkjet-Printing-Verfahren
Resiste für die Nanoimprint-Lithographie (NIL)
Die Nanoimprint Lithographie (NIL) ist eine sehr einfache und kostengünstige Technologie zur Herstellung von Strukturen mit Größen weniger Nanometer, die effizient in einem Prozessschritt auch auf großen Flächen realisiert werden kann. Hauptanwendungsfelder der NIL sind photonische Komponenten, unterschiedliche Bauelemente für die nächste Generation der Verbraucherelektronik, sowie Bio- und Life-Science-Sensoren.
Die micro resist technology GmbH bietet seit 1999 maßgeschneiderte Resistformulierungen für die Nanoimprint-Lithographie (NIL) an. Wir legen dabei besonderen Wert auf herausragende Filmbildungs- und Prägeeigenschaften sowie eine exzellente Plasmaätzstabilität und Strukturtreue. Weiterhin bieten wir hochinnovative Materialien, die eng an dem technischen Fortschritt in der Industrie entwickelt wurden. Wir sind in der Lage unsere Materialien an die Kundenwünsche anzupassen, sowohl in den gewünschten Schichtdicken, als auch in deren intrinsischen Materialeigenschaften. Die Nanoimprint-Resiste werden meist als Ätzmaske zur Strukturübertragung in unterschiedliche Substrate wie Si, SiO2, Al oder Saphir, eingesetzt.
Prinzipiell existieren zwei unterschiedliche NIL-Technologien: die thermische NIL (T-NIL), in der thermoplastische Polymere Verwendung finden, und die Photo-NIL bzw. UV-NIL, in der photo-vernetzbare Formulierungen eingesetzt werden. Mit unserer langjährigen Erfahrung sind wir in der Lage, den für Sie passenden Prozess und das am besten geeignetste Material für Ihre Anwendung zu finden. Kontaktieren Sie uns für tiefergehende Informationen.
micro resist technology bietet ein breites Portfolio an UV-härtbaren Hybridpolymer Produkten für mikrooptische Anwendungen. Durch ihre ausgezeichnete optische Transparenz und hohe thermische Stabilität sind diese besonders geeignet zur Herstellung polymerbasierter optischer Komponenten und Wellenleiter. Die Hauptanwendungsgebiete sind die Herstellung von Mikrolinsen, diffraktiven optischen Elementen (DOE), Gitterstrukturen sowie Singlemode- oder Multimode-Wellenleitern.
OrmoComp®: DE 30 210 075 433; IR 1 091 982 ; TW 100030626; OrmoClear®: DE 30 210 075 434; IR 1 091 359 ; TW 100030628; OrmoStamp®: DE 30 210 075 435; IR 1 092 621 ; TW 100030629; OrmoPrime®: DE 30 210 075 436
Positiv-Photoresiste für die UV-Lithographie (Mask Aligner-, Laser-, Grauton-Belichtung) und Elektronenstrahllithographie
Photoresiste für UV (Mask Aligner, Laser)/ Elektronenstrahl- und Tief-UV-Lithographie