Menu
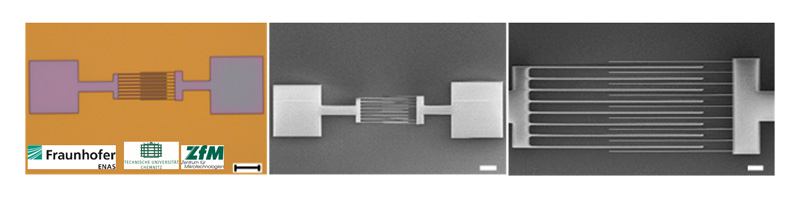
Optical microscope and SEM images of generated devices, i-line stepper & e-beam exposed - Courtesy of FhG-ENAS/ TUC-ZfM, Germany
The ongoing miniaturization of integrated circuits (IC‘s) and micro-electro-mechanical systems (MEMS) demands the fabrication of increasingly small and complex patterns with requirements for precision and resolution down to the nanometer scale. The mix & match approach or hybrid lithography, which is the combination of at least two different patterning techniques on same resist layer is one method to fabricate complex patterns with different dimensions ranging from µm down to below 100 nm scale with reduced e-beam writing time and shortened lithographical processing.
Here the use of ma-N 1400, a classical UV-sensitive negative resist, well suited as etch mask exhibiting high dry and wet etch resistance, is demonstrated in a mix & match approach.
Reference examples
Links to related product pages

micro resist technology is a single entry point for specialty chemicals used in micro and nano manufacturing in Europe. The portfolio of in-house products is complemented by the strategic sales of associated products that are manufactured by our international partners. Here we act as a high-service distributor and offer European medium-sized companies a wide range of complementary products from a single source, which can be used for both established and innovative production and manufacturing processes.
DuPont Electronic Solutions (formerly DOW Electronic Materials / Rohm and Haas Europe Trading ApS)
We offer products for semiconductor technologies, advanced packaging and dry film resists from our partner DuPont, with whom we have been working for more than 20 years.
Kayaku Advanced Materials, Inc. (formerly MicroChem Corp.)
We offer photoresists and specialty chemicals for MEMS and microelectronic applications from our partner Kayaku Advanced Materials, with whom we have been working for more than 20 years.
DJ MicroLaminates, Inc.
We offer dry film resists for MEMS, microfluidics and packaging applications from our partner DJ MicroLaminates, with whom we have been cooperating for over two years.
Dry films are ready-to-use polymer films as laminate foil with a high accuracy of the film thickness and excellent adhesion behaviour on various substrates. They are very simple in handling, photo-structurable and both as cut sheets and as roll material available.
Special designed functional materials from the product groups Hybrid Polymers, Photoresists, and Nanoimprint Polymers for the deposition and alternative patterning using inkjet printing process
Nanoimprint Lithography (NIL) is a straight forward, low cost, and high throughput capable technology for the fabrication of nanometer scaled patterns. Main application fields are photonics, next generation electronics, as well as bio- and sensor applications.
micro resist technology GmbH has provided tailor-made resist formulations for nanoimprint lithography (NIL) since 1999. The unique key features of our products are outstanding film forming and imprinting performance beside excellent pattern fidelity and plasma etch stability. Besides our highly innovative material developments in close contact to industrial needs, our strength is the ability to adjust our materials in film thickness as well as addressing certain needs of the specific use cases within the formulation. Our nanoimprint resists are mostly applied as an etch mask for pattern transfer into various substrates, like Si, SiO2, Al or sapphire.
Our portfolio covers materials for the classical thermal NIL (T-NIL), in which a thermoplastic polymer is used, as well as UV-NIL, in which a liquid formulation is photo crosslinked upon photo exposure. With our technological expertise and know-how we are able to find the right material for your process and applications. Please contact us for your technical support!
micro resist technology offers a broad portfolio of UV-curable hybrid polymer products for micro-optical applications. Their excellent optical transparency and high thermal stability makes them perfectly suitable for the production of polymer-based optical components and waveguides. The main fields of application are micro lenses, diffractive optical elements (DOE), gratings, and single-mode or multi-mode waveguides.
OrmoComp®: DE 30 210 075 433; IR 1 091 982 ; TW 100030626; OrmoClear®: DE 30 210 075 434; IR 1 091 359 ; TW 100030628; OrmoStamp®: DE 30 210 075 435; IR 1 092 621 ; TW 100030629; OrmoPrime®: DE 30 210 075 436
Positive Photoresists for UV lithography (mask aligner, laser, greyscale exposure) and e-beam lithography
Photoresists for UV (mask aligner, laser)/ DUV and e-beam lithography